半導体プロセス – エッチング
1, エッチング工程の分類:
半導体製造におけるエッチングプロセスには主に 2 種類あります: ドライエッチングとウェットエッチング. ドライエッチングは3つに分かれます: プラズマエッチング, イオンビームスパッタリングエッチング、反応性イオンエッチング (りえ). もちろん, エッチングはグラフィックエッチングとグラフィックエッチングに分けることもできます. フォトレジストなどをマスクとして使用したパターンエッチング, エッチングの裸の部分だけを取り除きます, マスクがない場合、パターン化されたエッチングは実行されません。.
2, エッチングの目的と問題点:
グラフィックの転送または複製では、精度はいくつかのプロセスパラメータに依存します。: 不完全なエッチング, オーバーエッチング (オーバーエッチ), 穴あけエッチング, さまざまな異方性の比率と辺の選択 / 各種等方性エッチング.
エッチングが不完全: 理由として考えられるのは、, まず最初に, エッチング時間が短すぎることと、, 第二に, エッチングされる膜の厚さが均一でないこと.
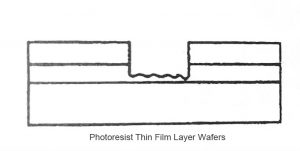
オーバーエッチング: あらゆるエッチング工程において, 表面層の厚さの変動を考慮して、ある程度の計画的なオーバーエッチングが常に行われます。, またはプロセスの次のステップのために.
等方性と異方性: 等方性とは、エッチングが全方向に行われることを意味します; 異方性はその逆です, 異方性によりより良いエッチングパターンが得られます (垂直側面) 等方性よりも.
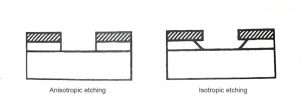
ドリルエッチング: 最表面から底面までエッチングが行われるため、最表面もエッチングされ、側面に面取り面が形成されます。. このアクションがフォトレジストのエッジの下にエッチングされる場合, ドリルエッチングとも言えます.
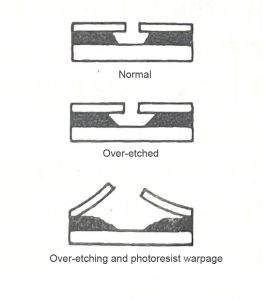
半導体プロセス – エッチング
選択率: 2 つの異なる材料における同じエッチング条件を指し、その比よりも速いエッチング速度を示します。. 例えば: マスクとしてのフォトレジストをエッチングする必要がある場合 SIO2, ドライエッチングあり, それから同時にエッチングを考慮する必要があります, フォトレジストとSIO2のエッチング比. そうしないと、マスクがエッチングされたときにフォトレジストが残ってしまいます。, SIO2 は必要な要件に合わせてエッチングされていません.
均一: ウェーハ全体のエッチングプロセスの尺度です, またはバッチ全体, またはパラメータのバッチ間エッチング機能. 不均一なエッチングにより追加のオーバーエッチングが発生するため、均一性は選択比と密接に関係しています。. 均一性に関する問題の一部は、パターンのサイズと密度に関連するエッチング速度とエッチングプロファイルの結果として発生します。. 小さなウィンドウパターンではエッチング速度が遅くなります, また、アスペクト比の高い小さなサイズのパターンでもエッチングを停止することができます。, アスペクト比依存エッチングとして知られる現象 (やけど), マイクロローディング効果としても知られています. 均一性を向上させるには, ウェーハ表面へのARDE効果は最小限に抑える必要があります.
上記パラメータに加えて, 残留物, ポリマー, プラズマによるダメージ, 粒子の汚れや粒子の汚れも、実際の生産におけるエッチング技術のパラメータです。.
3, まとめ:
ウェットエッチング: ウェットスプレーエッチング, 浸漬エッチング.
利点: より低いコストで, バッチでもよい, 固体酸化物形燃料電池.
短所: 1, 2umを超えるグラフィックサイズに制限される; 2, 等方性, 側面腐食が発生すると、側面に一定の傾斜が形成されます。; 3, ウェットエッチングでは、リンスおよび乾燥ステップの後に必要となる; 4, さまざまな腐食剤は有毒であるだけでなく、汚染される可能性もあります; 5, フォトレジストの接着力の低下により、穴が開いて腐食が発生します。.
ドライエッチング: プラズマ, イオンミリングと反応性イオンエッチング (りえ)
利点: 選択率が良い, より小さなグラフィックサイズを達成できる, 精度などを正確に制御できる.
短所: 遅くて高価な.
半導体プロセス – エッチング